封装的内容 (1)通过一定的结构设计、工艺设计、电设计、热设计和可靠性设计制造出合格的外壳或引线框架等主要零部件; (2) 改进封装结构、确定外形尺寸,使之达到通用化、标准化,并向多层次、窄节距、多引线、小外形和高密度方向发展; (3) 保证自硅晶圆的减薄、划片和分片开始,直到芯片粘接、引线键合和封盖等一系列封装所需工艺的正确实施,达到一定的 规模化和自动化;
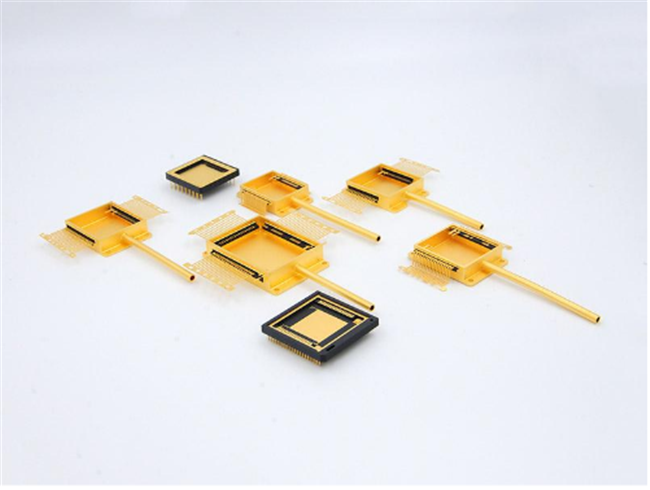
插装型封装之一,引脚从封装两边引出,封装资料有塑料和陶瓷两种DIP是最遍及的插装型封装,使用范围包含规范逻辑IC,存贮器LSI,微机电路等。 PLCC (Plastic Leaded Chip Carrier) PLCC封装方法,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多PLCC封装适合用T表面装置技术在PCB上装置布线,具有外形尺寸小,可靠性高的长处。

其中所有元件在结构上已组成一个整体,使电子元件向着微小型化、低功耗、智能化和高可靠性方面迈进了一大步。它在电路中用字母“IC”表示。 半导体集成电路是由半导体芯片、内部键合连接线和封装外壳组成的。它的核心是半导体芯片,但是把芯片直接与外电路连接是困难的,因此有内部连接线,为了保护芯片不易受到机械和化学等损伤,要有封装外壳。